投影物镜波像差是影响步进扫描投影光刻机性能的关键指标,并直接影响到光刻机成像质量、光刻分辨率、特征尺寸以及均匀性等重要参数。投影光刻机的成像系统一般可以表征为由光源与光瞳组成的部分相干成像系统,此类成像系统的空间像光强分布需要用一个双线性模型来描述。特别是当引入波像差的情况下,基于此双线性描述的空间像计算将非常复杂。我们提出几种能够适用于部分相干照明条件的波像差原位检测技术,该技术能够精确检测Zernike系数达到37级(即Z37),甚至64级。
(1) 基于灵敏度解析函数的波像差原位检测理论与方法
通过深入研究光刻机中的部分相干成像理论,我们对部分相干成像模型进行了简化,推导获得了用于波像差快速检测的两个线性模型(分别用与检测Zernike多项式中的奇像差项与偶像差项),并提出了一种基于光强频谱灵敏度矩阵的波像差在线检测新技术,后又将这种技术扩展到一种广义的表达,使之适用于任意形状的光源。该检测技术采用制造工艺最为简易的二元光栅结构作为掩模标记,无需集成或设计复杂掩模标记,具有高精度、快速、易操作等诸多优点,可以广泛应用于光刻机投影物镜波像差的原位检测。
(2) 基于单次空间像测量的波像差直接检测理论与方法
最近,我们提出了一种基于单次空间像测量的波像差检测方法。此方法适用于部分相干照明系统,并且只需要对离焦空间像进行一次测量。我们对部分相干成像模型进行了简化,推导获得了用于波像差快速检测的线性模型,依据此线性模型得到了波像差灵敏度的广义通用矩阵。该灵敏度矩阵由一系列解析核函数组成,直接将测量得到的空间像光强分布和未知待求解的Zernike系数联系了起来。逆向的Zernike系数求解问题,采用最小二乘法实现,为保证方程的适定性,对检测用掩模图形进行了优化设计。
(3) 基于二阶波像差模型高效算法的波像差原位检测理论与方法
为了测量波像差较大情况下的Zernike系数,需要实现投影光刻机中高阶波像差模型的快速计算,为此我们引入了信号处理中的三阶互相关算子。通过将Hopkins模型中的交叉传递矩阵分成很多项三阶互相关算子,由Zernike系数表征的波像差系统中的空间像可以根据各项系数分离开来,并且用快速的方法计算得到。基于以上空间像模型,我们提出一种利用空间像光强与Zernike系数的二阶关系实现投影光刻机波像差原位检测的方法。在二阶波像差模型的基础上,使用在优化设计的掩模标记上的离焦扫描空间像,用迭代算法实现波像差检测。仿真结果表明此方法在像差较大的情况下仍能保证较小的误差,有良好的适用性。

图1 圆形平滑光源照明条件下,不同Zernike级次的奇像差灵敏度核函数的光瞳面分布

图2 四级平滑光源照明条件下,基于灵敏度解析函数的波像检测仿真结果

图3 基于单次空间像测量的波像差检测模型中掩模图形标记的优化结果

图4 波像差检测仿真结果:(a)未知待求解的波像差;(b)复原的波像差;(c)波像差复原误差

图5 三阶互相关算子的数学内涵表征

图6 波像差检测的正向建模和逆向求解流程图
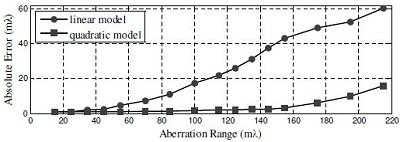
图7 二阶波像差检测模型与简化线性模型的测量误差比较
代表性论文
S. Xu, C. W. Zhang, H. Q. Wei, and S. Y. Liu, "A single-image method of aberration retrieval for imaging systems under partially coherent illumination," J. Opt. 16(7), 072001 (2014). (URL, PDF)
S. Y. Liu, X. J. Zhou, W. Lv, S. Xu, and H. Q. Wei, "Convolution-variation separation method for efficient modeling of optical lithography," Opt. Lett. 38(13), 2168-2170 (2013). (URL, PDF)
S. Y. Liu, S. Xu, X. F. Wu, and W. Liu, "Iterative method for in situ measurement of lens aberrations in lithographic tools using CTC-based quadratic aberration model," Opt. Express 20(13), 14272-14283 (2012). (URL, PDF)
S. Y. Liu, W. Liu, and T. T. Zhou, "Fast algorithm for quadratic aberration model in optical lithography based on cross triple correlation," J. Micro/Nanolith. MEMS MOEMS 10(2), 023007 (2011). (URL, PDF)
S. Y. Liu, W. Liu, and X. F. Wu, "Fast evaluation of aberration-induced intensity distribution in partially coherent imaging systems by cross triple correlation," Chin. Phys. Lett. 28(10), 104212 (2011). (URL, PDF)
W. Liu, S. Y. Liu, T. L. Shi, and Z. R. Tang, "Generalized formulations for aerial image based lens aberration metrology in lithographic tools with arbitrarily shaped illumination sources," Opt. Express 18(19), 20096-20104 (2010). (URL, PDF)
W. Liu, S. Y. Liu, T. T. Zhou, and L. J. Wang, "Aerial image based technique for measurement of lens aberrations up to 37th Zernike coefficient in lithographic tools under partial coherent illumination," Opt. Express 17(21), 19278-19291 (2009). (URL, PDF)