1. 纳米结构计算测量:问题与求解方法


为了实现纳米制造工艺的可控性,在纳米制造中对纳米结构的形貌参数进行快速、低成本、非破坏性地精确测量具有十分重要的意义。光学测量技术因其速度快、低成本、无接触、非破坏和易于在线集成等优点,近年来受到越来广泛的关注。光学测量技术可分为无模型测量技术和基于模型的测量技术。无模型测量技术如基于传统光学显微镜的测量技术,直接通过边缘识别的方式获得待测样品几何尺寸。这种“所见即所得”的测量技术由于受到衍射极限的影响,一般难以测量200 nm以下的结构。与之相比,基于模型的测量技术,并非直接通过边缘识别,而是首先对样品进行正向的光学特性建模,进而将模型生成数据与仪器测量数据进行比较,通过某种优化算法,最终...[更多]
2. 光学偏振散射测量:仪器开发与应用


光学偏振散射测量技术如基于传统光谱椭偏仪的散射测量技术,由于具有测量速度快、成本低、无接触、非破坏和易于集成等优点,目前已经发展成为批量纳米制造中纳米结构形貌参数在线测量的一种重要手段。光谱偏振散射测量技术本质上是一种基于模型的测量技术,其成功与否主要取决于两个方面的关键技术,一是如何获得精确的偏振散射测量数据,二是如何从测量数据中快速准确地反演得到待测纳米结构的形貌参数。其中,前者涉及到偏振散射测量设备的开发,而后者为偏振散射测量数据分析内容,具体涉及到纳米结构的计算测量理论与方法。为了获得精确的偏振散射测量数据,课题组针对不同的纳米结构测量需求,围绕光的偏振以及散射等核心内容,研制...[更多]
3. 计算光刻:正向光学成像建模与逆向光源掩模优化

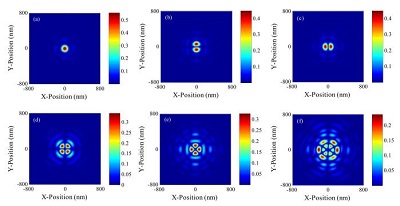
目前,工业界广泛使用193 nm波长的浸没式光刻机来制造关键尺寸远小于波长的集成电路芯片,制造过程相当于用粗大的刷子画细小的线条,已经远远超出了物理范畴上的极限分辨率。计算光刻技术使得这种“用大刷子画细线条”的制造变成可能,并且保证了大批量的制造,它已经成为了摩尔定律的主要推动力之一。计算光刻的原理是使用计算仿真的方法,将包含照明光源、掩模、投影物镜系统的成像系统和光刻胶曝光、刻蚀等工艺过程联系起来,然后通过数学的方法进行掩模图形分拆与校正、光源照明形状优化、投影物镜参数调节等方式增强分辨率。计算光刻的成功与否极大程度上取决于两大关键技术,即快速准确的正向光学成像建模与高效鲁棒的逆向光源掩模...[更多]
4. 光刻机波像差原位检测:空间像快速算法与波像差检测方法


投影物镜波像差是影响步进扫描投影光刻机性能的关键指标,并直接影响到光刻机成像质量、光刻分辨率、特征尺寸以及均匀性等重要参数。投影光刻机的成像系统一般可以表征为由光源与光瞳组成的部分相干成像系统,此类成像系统的空间像光强分布需要用一个双线性模型来描述。特别是当引入波像差的情况下,基于此双线性描述的空间像计算将非常复杂。我们提出几种能够适用于部分相干照明条件的波像差原位检测技术,该技术能够精确检测Zernike系数达到37级(即Z37),甚至64级。[更多]
5. 微纳深沟槽结构基于模型的红外反射谱测量方法


在微电子和微机电系统设计与制造工艺过程中,目前广泛采用了高深宽比的深沟槽结构,如最新的动态随机存储开始采用复杂的瓶状深沟槽电容器结构,深度反应离子刻蚀工艺可以很容易制作深宽比达50:1以上的集成电路和微机电系统结构。当深沟槽器件的尺寸不断缩小且集成度不断提高时,深沟槽底部的宽度特征尺寸已成为一个关键参数;随着沟槽尺寸不断缩小且沟槽剖面形貌更为复杂时,监测沟槽深度相关的特征(如瓶颈深度)对于保证工艺控制已变得越来越迫切。近年来,一种新的光学测量方法,即基于模型的红外反射谱测量方法被用于高深宽比深沟槽结构的测量。在基于模型的红外反射谱测量方法中,通过等效介质理论将深沟槽结构等效为多层薄膜堆栈模...[更多]
6. MEMS微结构动态特性光学测量方法及系统

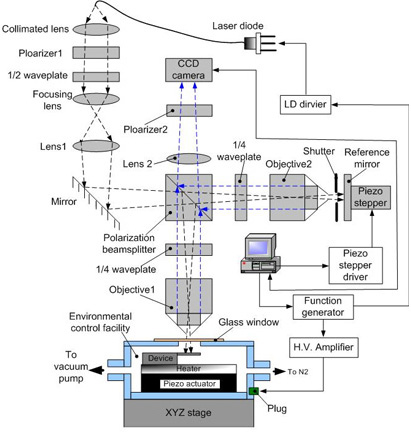
微机电系统(MEMS)测试特别是动态特性表征对其设计、制造和可靠性运行具有非常重要的意义。MEMS结构本身的极微小尺寸(微米级到纳米级)和超高频振动响应(数千赫兹到数兆赫兹),决定了MEMS动态特性表征的困难性和复杂性。为此,我们研究基于光学的非接触式无损测量方法及测量系统,以实现MEMS高频高速运动的三维可视化测量及其动力学特性的可编程自动测试与分析。[更多]